这哥们不是北大球系的嘛,球系连正经物理都没学全懂个球光刻机。
EUV光刻机为什么要把光线反射十四次?
版主: Softfist
#23 Re: EUV光刻机为什么要把光线反射十四次?
14次还是9次都不是关键,hhcare 写了: 2025年 2月 8日 22:51 因为不是反射14次, 如果你说EXE可能接近, 但是EXE我是从来看着都失败的产品
。。。。。我不是第一次说EXE会失败的,
intel会死在这上面。
说的是为什么要这么多次
核心问题是x射线只能掠射
嘿嘿、
耗子懂个鸡巴
#24 Re: EUV光刻机为什么要把光线反射十四次?
EUV(极紫外)光刻机的光路设计是其核心技术之一,涉及复杂的光学系统和精密的光学元件。以下是EUV光刻机光路设计的具体细节,包括光路的各个阶段和反射镜的作用。
1. EUV光刻机光路概述
EUV光刻机的光路可以分为以下几个主要阶段:
光源到照明系统:将EUV光从光源引导到照明系统。
照明系统到掩模版(Reticle):将光线均匀化并照射到掩模版上。
掩模版到投影光学系统:将掩模版上的图案通过投影光学系统缩小并投射到晶圆上。
在整个光路中,光线需要经过多次反射(通常为13-14次),以确保光线的均匀性、聚焦精度和成像质量。
2. 具体光路设计
阶段1:光源到照明系统
光源:EUV光刻机使用LPP(激光激发等离子体)光源,通过高功率CO₂激光轰击锡滴产生13.5纳米的EUV光。
收集镜(Collector Mirror):
光源发出的EUV光首先被一个椭球形的收集镜反射。
收集镜的作用是将发散的光线聚焦并引导到照明系统。
反射次数:1次。
阶段2:照明系统到掩模版
照明系统:
照明系统由多个反射镜组成,用于将光线均匀化并调整其角度分布。
主要反射镜包括:
场镜(Field Mirror):用于调整光线的空间分布。
光瞳镜(Pupil Mirror):用于调整光线的角度分布。
反射次数:4-6次。
掩模版(Reticle):
光线经过照明系统后,照射到掩模版上。
掩模版上刻有芯片的图案,光线通过掩模版后携带图案信息。
阶段3:掩模版到投影光学系统
投影光学系统(Projection Optics):
投影光学系统由多个反射镜组成,用于将掩模版上的图案缩小并精确投射到晶圆上。
主要反射镜包括:
缩小镜(Reduction Mirror):将图案缩小(通常缩小4倍)。
像差校正镜(Aberration Correction Mirror):校正光路中的像差。
反射次数:6-8次。
晶圆(Wafer):
光线最终投射到晶圆上,形成高分辨率的图案。
3. 总反射次数
光源到掩模版:1次(收集镜) + 4-6次(照明系统) = 5-7次。
掩模版到晶圆:6-8次(投影光学系统)。
总反射次数:13-14次。
4. 光路设计的关键技术
多层膜反射镜:
所有反射镜表面都涂有多层薄膜(通常是硅和钼的交替层),以高效反射13.5纳米的光。
单次反射效率约为70%,因此需要多次反射来补偿光能损失。
像差校正:
通过精确设计反射镜的曲率和位置,校正光路中的像差(如球差、彗差、散光等)。
热管理:
多次反射导致光能损失转化为热量,需要通过冷却系统防止反射镜热变形。
光源功率:
为了补偿光能损失,EUV光刻机需要极高功率的光源(通常为250瓦以上)。
5. 光路设计的挑战
反射镜制造精度:
反射镜的表面粗糙度必须控制在原子级别(约0.1纳米)。
反射镜的形状和曲率必须高度精确,通常使用离子束抛光等技术实现。
光路对准:
所有反射镜的位置和角度必须精确对准,以确保光线准确传递。
光能损失:
多次反射导致光能损失巨大,需要通过高功率光源和高效反射镜来补偿。
6. 总结
EUV光刻机的光路设计是其核心技术之一,通过13-14次反射将EUV光从光源传递到晶圆。这种设计虽然复杂且成本高昂,但它是实现先进制程芯片制造的关键技术。通过精确的光学设计和制造工艺,EUV光刻机能够在晶圆上实现纳米级精度的图案转移。
1. EUV光刻机光路概述
EUV光刻机的光路可以分为以下几个主要阶段:
光源到照明系统:将EUV光从光源引导到照明系统。
照明系统到掩模版(Reticle):将光线均匀化并照射到掩模版上。
掩模版到投影光学系统:将掩模版上的图案通过投影光学系统缩小并投射到晶圆上。
在整个光路中,光线需要经过多次反射(通常为13-14次),以确保光线的均匀性、聚焦精度和成像质量。
2. 具体光路设计
阶段1:光源到照明系统
光源:EUV光刻机使用LPP(激光激发等离子体)光源,通过高功率CO₂激光轰击锡滴产生13.5纳米的EUV光。
收集镜(Collector Mirror):
光源发出的EUV光首先被一个椭球形的收集镜反射。
收集镜的作用是将发散的光线聚焦并引导到照明系统。
反射次数:1次。
阶段2:照明系统到掩模版
照明系统:
照明系统由多个反射镜组成,用于将光线均匀化并调整其角度分布。
主要反射镜包括:
场镜(Field Mirror):用于调整光线的空间分布。
光瞳镜(Pupil Mirror):用于调整光线的角度分布。
反射次数:4-6次。
掩模版(Reticle):
光线经过照明系统后,照射到掩模版上。
掩模版上刻有芯片的图案,光线通过掩模版后携带图案信息。
阶段3:掩模版到投影光学系统
投影光学系统(Projection Optics):
投影光学系统由多个反射镜组成,用于将掩模版上的图案缩小并精确投射到晶圆上。
主要反射镜包括:
缩小镜(Reduction Mirror):将图案缩小(通常缩小4倍)。
像差校正镜(Aberration Correction Mirror):校正光路中的像差。
反射次数:6-8次。
晶圆(Wafer):
光线最终投射到晶圆上,形成高分辨率的图案。
3. 总反射次数
光源到掩模版:1次(收集镜) + 4-6次(照明系统) = 5-7次。
掩模版到晶圆:6-8次(投影光学系统)。
总反射次数:13-14次。
4. 光路设计的关键技术
多层膜反射镜:
所有反射镜表面都涂有多层薄膜(通常是硅和钼的交替层),以高效反射13.5纳米的光。
单次反射效率约为70%,因此需要多次反射来补偿光能损失。
像差校正:
通过精确设计反射镜的曲率和位置,校正光路中的像差(如球差、彗差、散光等)。
热管理:
多次反射导致光能损失转化为热量,需要通过冷却系统防止反射镜热变形。
光源功率:
为了补偿光能损失,EUV光刻机需要极高功率的光源(通常为250瓦以上)。
5. 光路设计的挑战
反射镜制造精度:
反射镜的表面粗糙度必须控制在原子级别(约0.1纳米)。
反射镜的形状和曲率必须高度精确,通常使用离子束抛光等技术实现。
光路对准:
所有反射镜的位置和角度必须精确对准,以确保光线准确传递。
光能损失:
多次反射导致光能损失巨大,需要通过高功率光源和高效反射镜来补偿。
6. 总结
EUV光刻机的光路设计是其核心技术之一,通过13-14次反射将EUV光从光源传递到晶圆。这种设计虽然复杂且成本高昂,但它是实现先进制程芯片制造的关键技术。通过精确的光学设计和制造工艺,EUV光刻机能够在晶圆上实现纳米级精度的图案转移。
#26 Re: EUV光刻机为什么要把光线反射十四次?
我跟你说EUV八九十年代提出来的时候的确是四镜, 略入射。 这个我做过,
后来不是了。
略入射的X-ray 用来测coating我都做过。
你以为我换那么多老板干啥的?!
尼玛, 你的只是太陈旧了, 根本没有进过实验室, 更不要提现在的新技术了。
至于上次X光源电子打铜板等等, 我都是用过的。
弃婴你别丢人了好不好。 随便你看看EUV反射镜就知道不是掠入射了。
#30 Re: EUV光刻机为什么要把光线反射十四次?
行了,人家问你为什么这么多镜,根本原因就是x射线只能掠射,所以反光镜的曲率都很小hhcare 写了: 2025年 2月 8日 22:57 我跟你说EUV八九十年代提出来的时候的确是四镜, 略入射。 这个我做过,
后来不是了。
略入射的X-ray 用来测coating我都做过。
你以为我换那么多老板干啥的?!
尼玛, 你的只是太陈旧了, 根本没有进过实验室, 更不要提现在的新技术了。
至于上次X光源电子打铜板等等, 我都是用过的。
弃婴你别丢人了好不好。 随便你看看EUV反射镜就知道不是掠入射了。




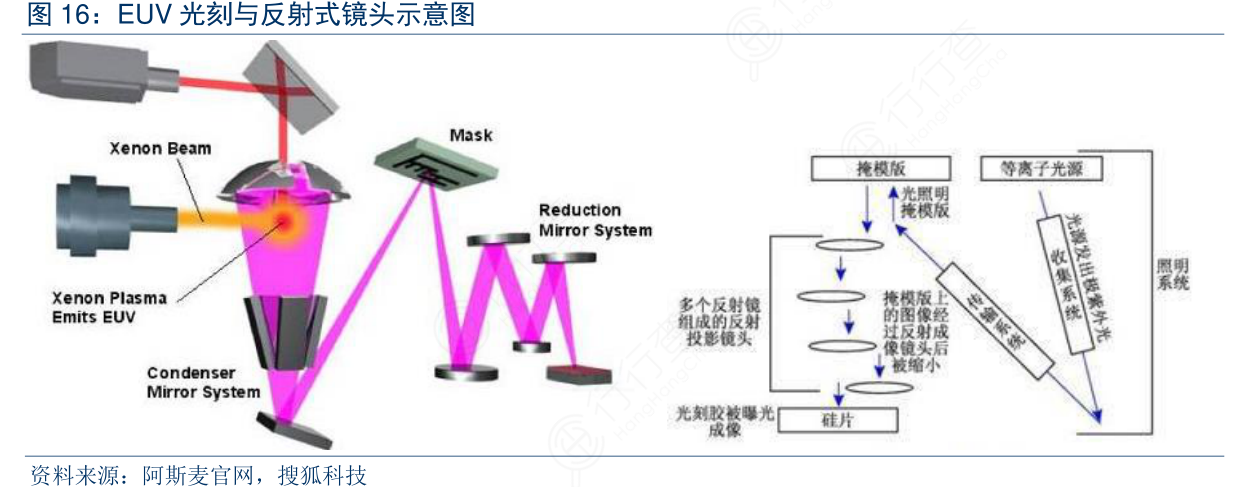
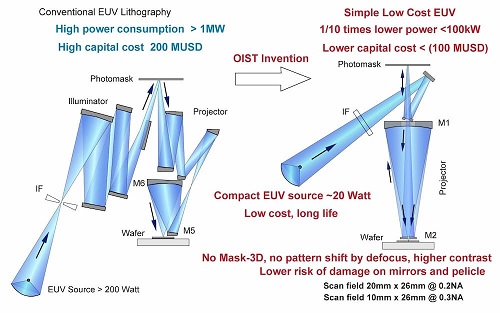



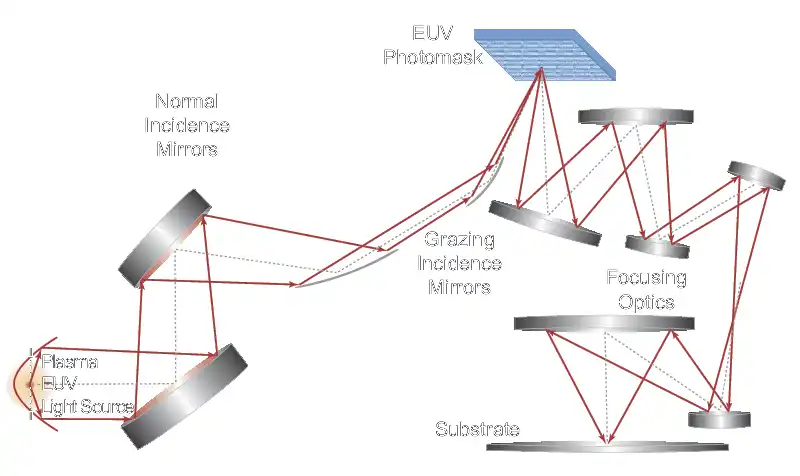 [/url]
[/url]